Intel 在今年舉辦睽違兩年的架構日活動,不過受到武漢肺炎疫情影響,內容轉為線上方式呈現,而此次作為主講的是擔任 Intel 副總裁暨首席架構師的傳奇人物 Raja Koduri ,在介紹今年重點的 Tiger Lake 與 Xe 前, Raja 也強調 Intel 正處在轉型的階段,從過往的 CPU 硬體公司轉型成具彈性的異構與軟硬並行的型態。

Intel 的轉型是有其必要與必然性的,畢竟目前的運算產業已經進入全新的世代,單一架構已經無法滿足市場對於運算的需求, Intel 也自多方面著手進行革新。
在 CPU 的發展歷程,現在也將進入新階段,從最初的單一高效能巨核,藉多核分工提升運算力,現在則是自架構從面著手提升至整體性能。

Intel 也持續在半導體製程技術進行努力, Intel 認為製程不可能永無止盡突破,需要自其它方面提升電晶體的效率,如結構、材質、封裝等;像是製程上的持續改善,混合封裝與晶圓與晶圓之間的高速連接介面等,皆是在製程之外重要的技術。此外, Intel 也將在消費級的 Tiger Lake 使用 10nm 的 SuperFin 。
10nm SuperFin 是 Intel 10nm 新製程技術,特色是把 Intel 增強型 FinFET 與較業界公 5 倍容積效率的 SuperMIM 電容結合,於源極/汲極提供增強的磊晶,並改善柵極製程與額外柵極的間距,能夠提升應力並減小電阻,允許更多電流通過通道,並透過改進柵極製程驅動更高的通道遷移率,使電荷載子能更快速移動,額外柵極間距選項可謂需要極緻效能的特定晶片功能提供更高的驅動電流,同時新型薄阻障層降低 30% 通孔電阻,強化互連性能。
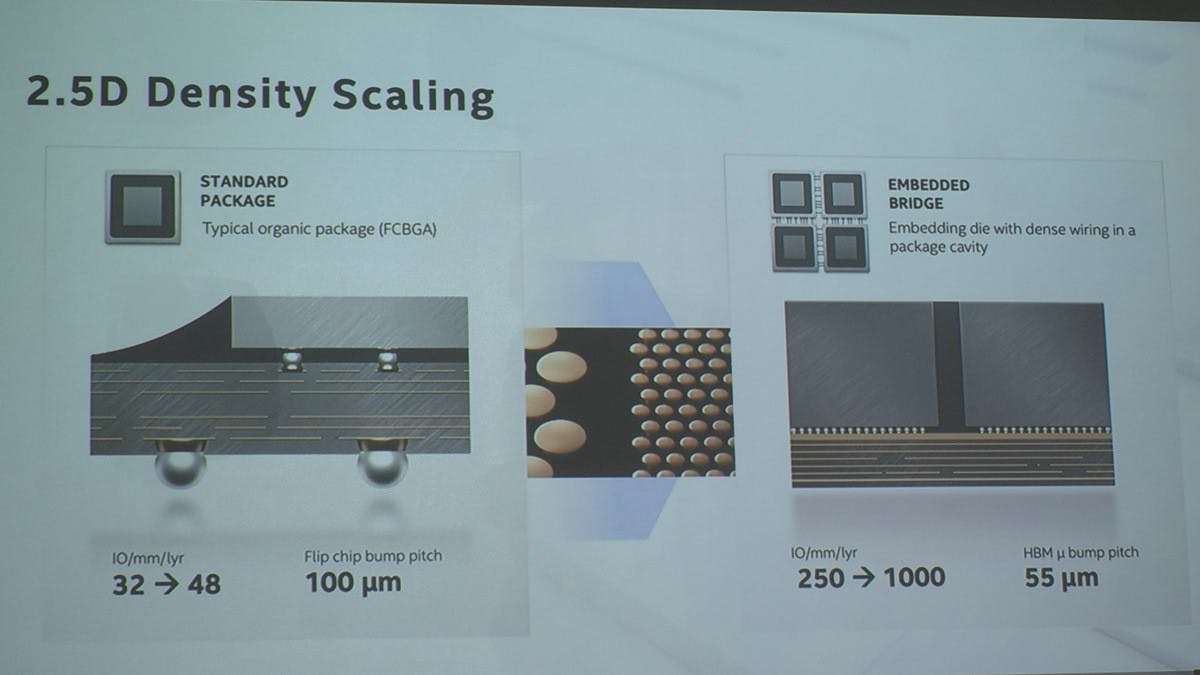

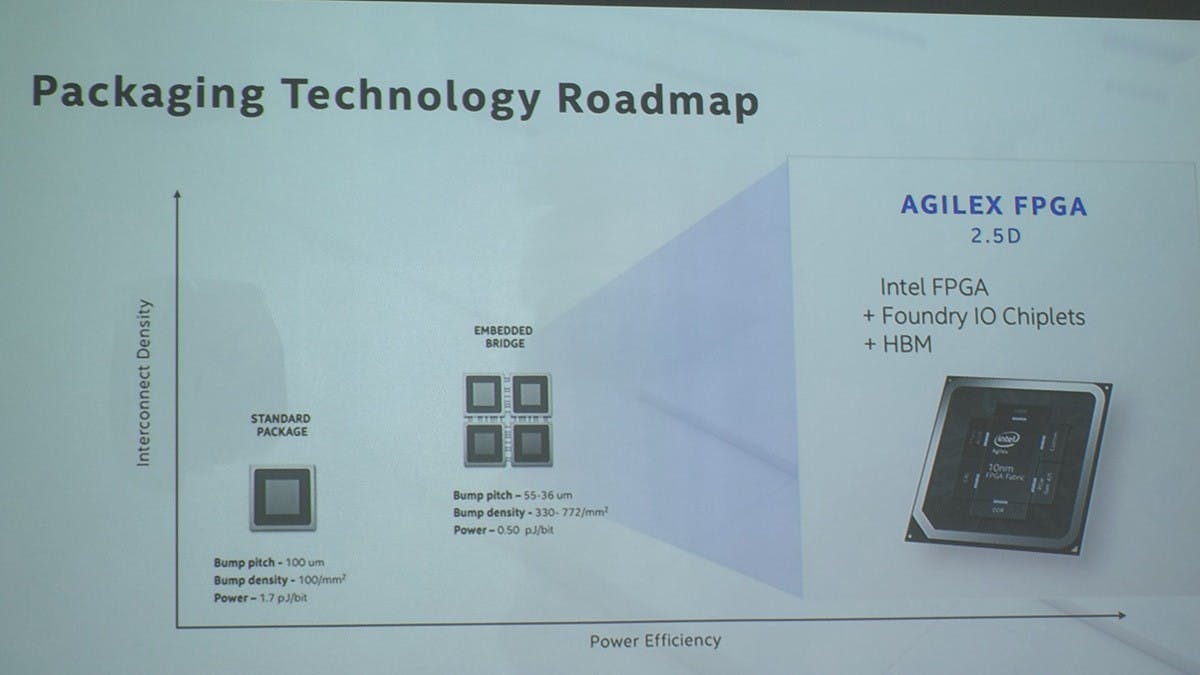
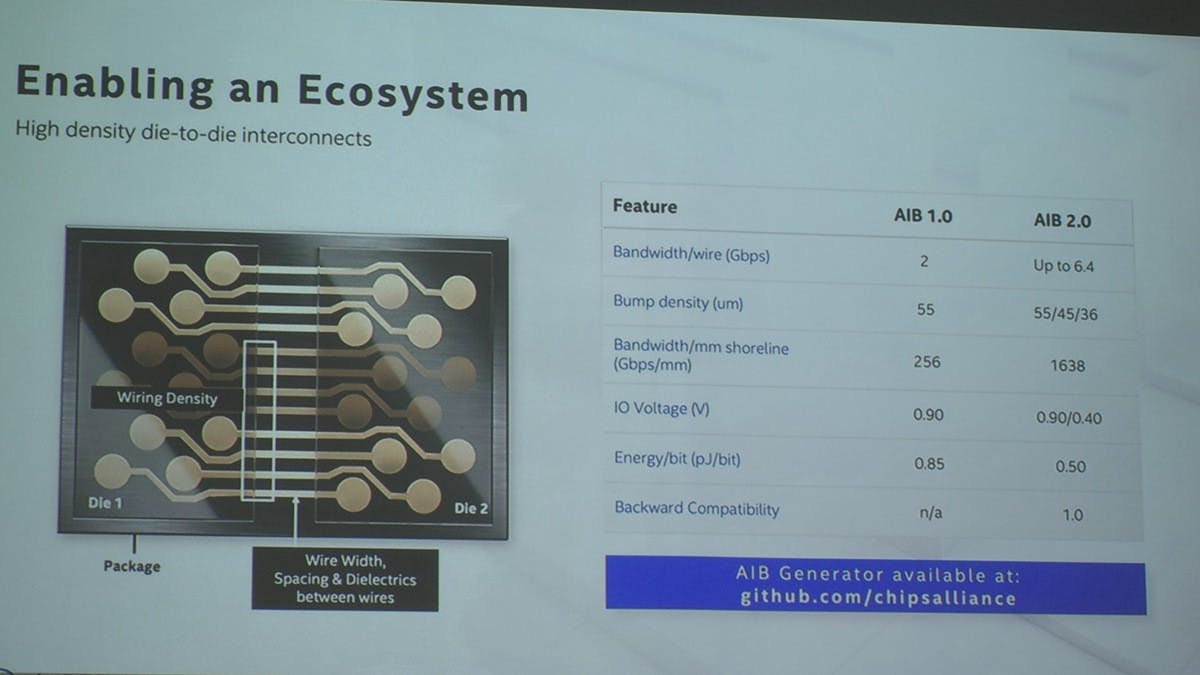



Intel 的混合封裝技術也在經年月累的演進下有了豐厚的成果,自藉由 2.5D 封裝的 Kaby Lake-G , Agilex FPGA 開始,今年所推出 Lake Lake 平台所採用的 3D 封裝,更將不同製程、架構的 CPU 與 GPU 進行混合封裝,達到前所未有的功耗效能;下一階段, Intel 也規劃了 Alder Lake 平台,將為 Intel 有史以來最佳功耗效能比的平台。 Intel 新一代的混合接合 Hybrid Bounding 測試晶片亦在今年第二季投片,此技術可取代當前主流熱壓接合的技術,能夠實現 10nm 以下凸點間距,提供更高互連密度、頻寬與低公耗。
同時, Intel 也指出不同的架構有各自擅長的領域,如 CPU 在非向量運算, GPU 的向量運算, AI 在 Matrix 運算,以及具高度彈性的 FPGA 等, Intel 的產品線也涵蓋這些領域,提供不同領域運算的需求。


Intel 認為,晶片設計也將逐漸自 SoC (系統級芯片)、 SiP (系統級混合封裝)邁入更彈性化的模組化 IP 組合, Intel 稱其為 Client 2.0 ,藉由將每個架構切割為多個小型模組,透過先進封裝與高速連接通道整合,能因應不同的需求進行組合搭配。要能實現 Client 2.0 ,如 AIB 、 CXL 高速芯片連接介面技術就扮演相當重要的角色。

在軟體面, Intel 也著重軟體環境與硬體結合帶來的效益,尤其以針對 AI 的 oneAPI ,已經陸續提供針對多種異構硬體的支援,且藉由持續改善的軟體,以相同的硬體亦能改善效能,也預計在明年釋出 oneAPI Gold ,屆時能夠提供更強大的 AI 性能。


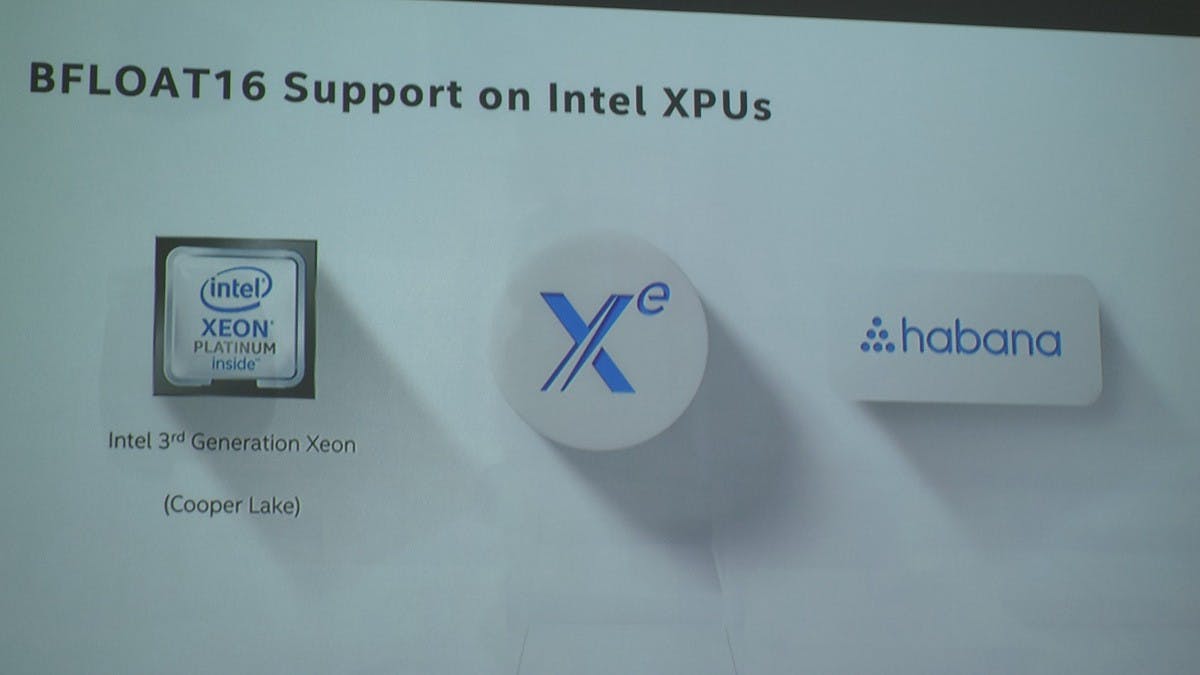
同時今年 Intel 也推出 BFLOAT16 ,是針對 AI 運算的新技術,能夠將 FP32 以 BFLOAT16 方式進行,僅需使用 FP16 的運算量達到 FP32 的精度水準,可大幅減少運算量並提高 AI 的訓練效率,當前已經在 Xeon 平台開始導入此技術。