材料科學對於新技術突破經常扮演重要角色,當前廣泛使用在半導體產業的有機材料恐怕將在 2030 年前遇到電晶體數量的極限,同時有機材料作為半導體載體本身的耗電也不太理想,同時也有膨脹與彎曲的限制; Intel 搶在舉辦 2023 Intel Innovation 大會前夕,展示預計在 2026 年至 2030 年量產的下一代先進封裝用玻璃基板,相較現行有機基板具備超低平坦度、更加的熱穩定性與機械穩定性,有助提升基板的互聯密度,將為下一代人工智慧等數據密集型工作負載的高密度、高效能晶片奠定基礎。

▲ Intel 的玻璃基板技術將結合小晶片架構與先進封裝於 2030 年實現單一封裝一兆個電晶體的願景
Intel 在近十多年來就投入與評估玻璃基板取代有機基板的可能性,承襲 Intel 在 1990 年率先引領產業自陶瓷封裝轉向有機封裝,同時也是第一家實現鹵素與無鉛封裝技術、以及首個導入基於主動 3D 堆疊的先進嵌入是經歷技術發明者。玻璃基板將為 Intel 在超越 18A 製程節點的下一個運算時代帶來前專性關注與願景。
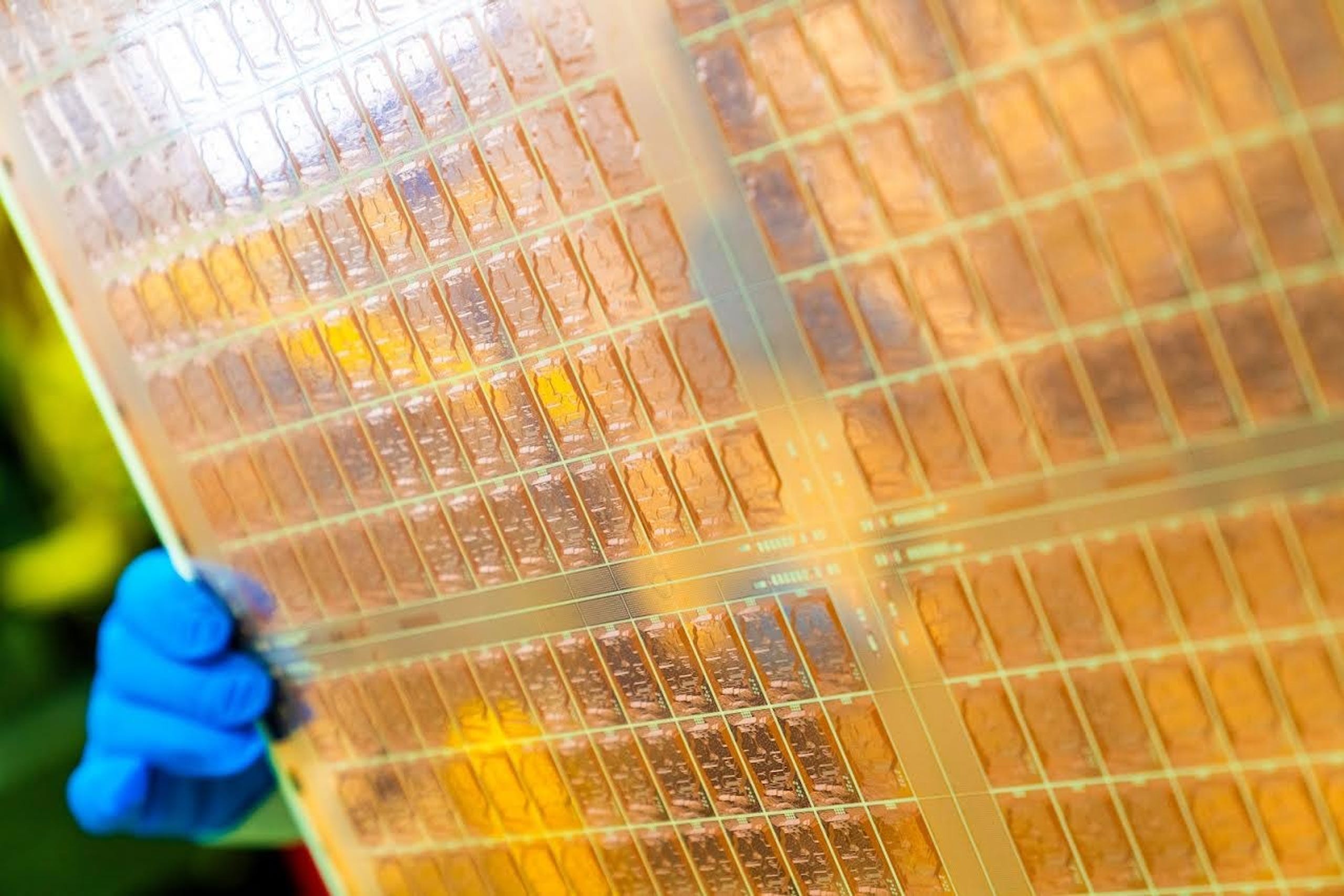
▲玻璃基板相較現在使用的有機基板於機械、物理、光學等特性都更為優異,同時在超大型封裝的良率也能提升
玻璃基板可說是因應「小晶片」 Chiplet 異質架構世代來臨的重要關鍵材料突破,為了迎接小晶片架構世代,提升訊號傳輸速度、功率傳輸、設計規則與封裝基板穩定性是重要的關鍵;玻璃基板相對現行有機基板具備出色的機械、物理與光學特性,可在單一封裝連接更多電晶體,使延展性能提昇並構成更大規模小晶片複合體的系統級封裝,有助以更高的彈性、更低的成本與功耗實現效能與密度增加。
而玻璃基板將率先用於對效能做苛求的市場,也就是如資料中心、 AI 、繪圖處理等需要更大體積封裝與更高速度的應用與工作負載;由於玻璃基板相對有機基板可承受更高溫度,圖案變形( Pattem Distortion )可降低 50% ,超低平坦度有助加大微影製程的焦距深度,並具備緊密的層間互連覆蓋所需的尺寸穩定性,玻璃基板能使互連密度提升達 10 倍,同時也由於機械特性更高,能實現高組裝良率的超大型封裝。
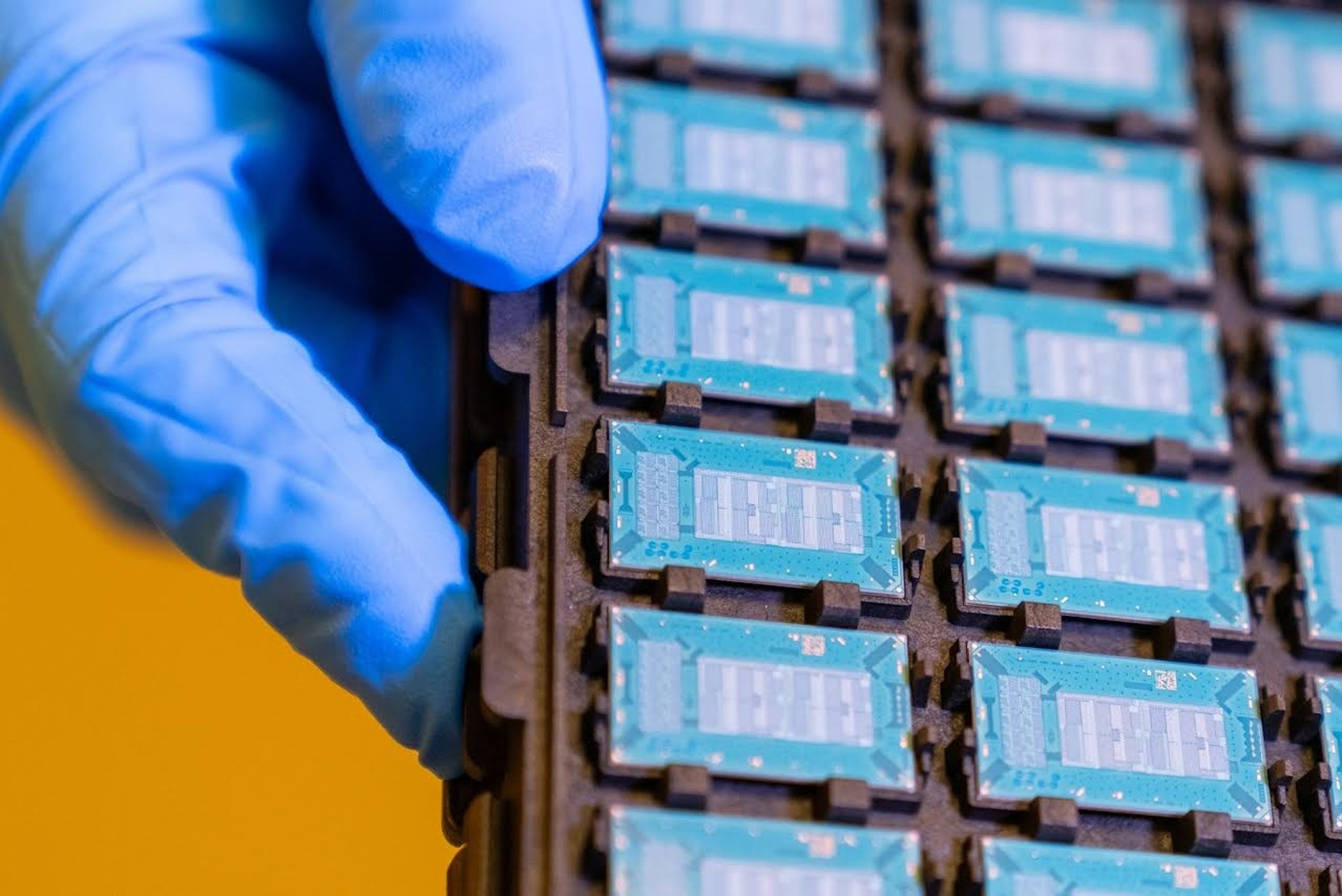
▲玻璃基板還可將電桿器與電容器嵌入玻璃進行加工,提升功率傳輸效率與實現高速訊號傳輸
玻璃基板所具備的高耐熱特質,使晶片架構是制定功率傳輸與訊號路由的設計規則能保有彈性,並無縫整合光學互聯,同時在更高溫度製程將電感器與電容器嵌入至玻璃進行加工,可提供更好的功率傳輸解決方案,不僅能降低功耗與實現所需的高速訊號傳輸,同時加速於 2030 年實現單一封裝納入 1 兆個電晶體的目標。






















