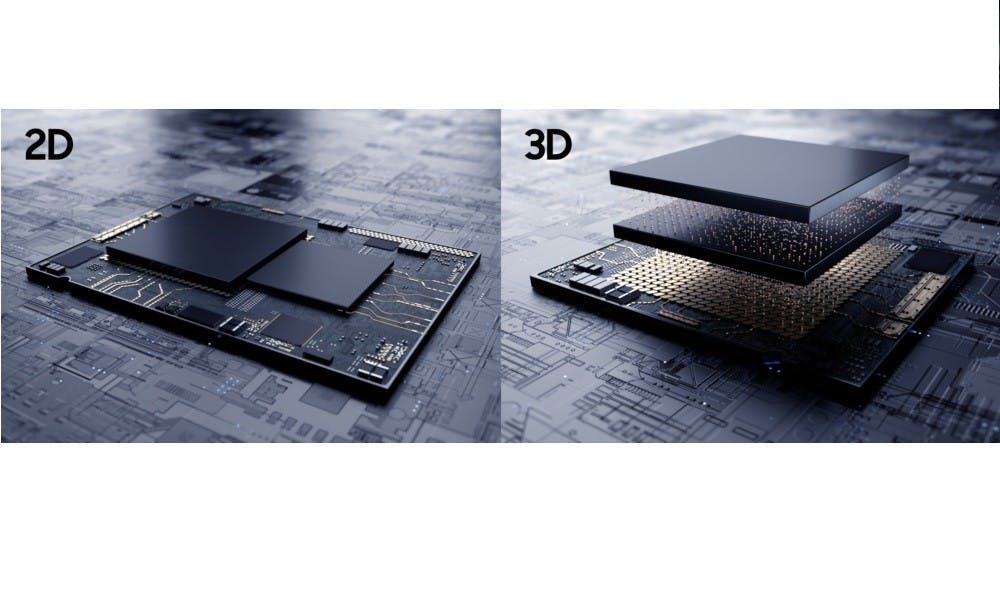
三星宣布 3D IC 封裝技術 X-Cube 完成 7nm 晶圓與 SRAM 封裝,將用於 5G 、 AI 、高效能運算與行動運算領域
拜高速通道技術持續突破,當前 IC 晶片的設計趨勢又有了變化,從過往的系統級單晶片 SoC 設計改以透過封裝方式集結更多功能的系統級封裝 SiP ,同時封裝方式亦從原本的 2D 往 3D 封裝發展,如 Intel 今年的 Lake Field 即是透過 3D 封裝方式把不同製程、不同機能的晶圓進行 3D 封裝的結果,而再 Hot Chips 前夕,三星電子也宣布其 3D 封裝技術 X-Cube ( eXtended-Cube )有了重大突破。 ▲三星的 X-Cube 封裝技術透過 TSV 技術使堆疊的晶圓進行更短路徑的傳輸溝通 三星此次的 X-Cube 3D 封裝是透過 TSV 技術把 SRA
4 年前